PECVD 的原理与故障分析
1PECVD的种类
1.1射频加强等离子体化学气相淀积(RF-PECVD)
等离子体化学气相淀积是在低压化学气相淀积的同时,行使辉光放电等离子对过程施加影响,在衬底上制备出多晶薄膜。这种方法是日本科尼卡公司在1994年提出的,其等离子体的产生方法多采用射频法,故称为RF-PECVD。其射频电场采用两种不同的耦合方式,即电感耦合和电容耦合[1]。
1.2甚高频等离子体化学气相淀积(VHF-PECVD)
采用RF-PECVD技术制备薄膜时,为了实现低温淀积,必须使用稀释的硅烷作为反应气体,因此淀积速度有限。VHF-PECVD技术因为VHF激发的等离子体比常规的射频产生的等离子体电子温度更低、密度更大[2],因而能够大幅度进步薄膜的淀积速率,在现实应用中获得了更广泛的应用。
1.3介质层阻挡放电加强化学气相淀积(DBD-PECVD)
DBD-PECVD是有绝缘介质插入放电空间的一种非平衡态气体放电(又称介质阻挡电晕放电或无声放电)。这种放电方式兼有辉光放电的大空间均匀放电和电晕放电的高气压运行特点,正渐渐用于制备硅薄膜中[3]。
1.4微波电子回旋共振等离子体加强化学气相淀积(MWECR-PECVD)
MWECR-PECVD是行使电子在微波和磁场中的回旋共振效应,在真空条件下形成高活性和高密度的等离子体进行气相化学反应。在低温下形成优质薄膜的技术。这种方法的等离子体是由电磁波激发而产生,其常用频率为2450MHz,通过改变电磁波光子能量可直接改变使气体分解成粒子的能量和生存寿命,从而对薄膜的生成和膜外观的处理机制产生庞大影响,并从根本上决定生成膜的结构、特征和稳固性[4]。
2PECVD设备的基本结构
2.1PECVD工艺的基本原理
PECVD技术是在低气压下,行使低温等离子体在工艺腔体的阴极上(即样品放置的托盘)产生辉光放电,行使辉光放电(或另加发热体)使样品升温到预定的温度,然后通入适量的工艺气体,这些气体经一系列化学反应和等离子体反应,最终在样品外观形成固态薄膜。其工艺原理示意图如图1所示。

在反应过程中,反应气体从进气口进入炉腔,渐渐扩散至样品外观,在射频源激发的电场作用下,反应气体分解成电子、离子和活性基团等。这些分解物发生化学反应,生成形成膜的初始成分和副反应物,这些生成物以化学键的情势吸附到样品外观,生成固态膜的晶核,晶核渐渐生长成岛状物,岛状物继承生长成延续的薄膜。在薄膜生长过程中,各种副产物从膜的外观渐渐离开,在真空泵的作用下从出口排出。
2.2PECVD设备的基本结构
PECVD设备重要由真空和压力控制体系、淀积体系、气体及流量控制、体系安全珍爱体系、计算机控制等部分组成。其设备结构框图如图2所示。
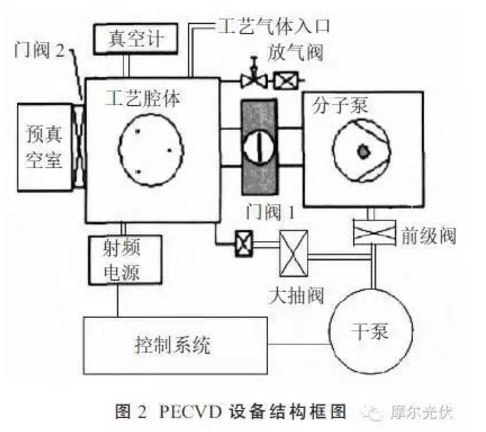
2.2.1真空和压力控制体系
真空和压力控制体系包括机械泵、分子泵、粗抽阀、前级阀、闸板阀、真空计等。为了削减氮气、氧气以及水蒸气对淀积工艺的影响,真空体系一样平常采用干泵和分子泵进行抽气,干泵用于抽低真空,与常用的机械油泵相比,可以避免油泵中的油气进入真空室污染基片。在干泵抽到肯定压力以下后,打开闸板阀,用分子泵抽高真空。分子泵的特点是抽本体真空能力强,尤其是除水蒸汽的能力特别很是强。
2.2.2淀积体系
淀积体系由射频电源、水冷体系、基片加热装配等组成。它是PECVD的核心部分。射频电源的作用是使反应气体离子化。水冷体系重要为PECVD体系的机械泵、罗茨泵、干泵、分子泵等提供冷却,当水温超过泵体要求的温度时,它会发出报警旌旗灯号。冷却水的管路采用塑料管等绝缘材料,不可用金属管。基片加热装配的作用使样品升温到工艺要求温度,除掉样品上的水蒸气等杂质,以进步薄膜与样品的附着力。
2.2.3气体及流量控制体系
PECVD体系的气源几乎都是由气体钢瓶供气,这些钢瓶被放置在有很多安全珍爱装配的气柜中,通过气柜上的控制面板、管道输送到PECVD的工艺腔体中。
在淀积时,反应气体的多少会影响淀积的速率及其均匀性等,因此必要严酷控制气体流量,通常采用质量流量计来实现正确控制。
3常见题目及影响工艺重要因素
3.1设备常见题目及处理措施
3.1.1无法起辉
无法起辉缘故原由和处理措施:
(1)射频电源故障,检查射频源电源功率输出是否正常。
(2)反应气体进气量小,检查气体流量计是否正常,若正常,则加大进气量进行试验。
(3)腔体极板清洁度不够,用万用表测量腔体上下极板的对地电阻,正常值应在数十兆欧以上,若非常,则清洁腔体极板。
(4)射频匹配电路故障,检查射频源反射功率是否在正常值范围内,若非常,则检查匹配电路中的电容和电感是否损坏。
(5)真空度太差,检查腔体真空度是否正常。
3.1.2辉光不稳
(1)电源电流不稳,测量电源供电是否稳固。
(2)真空室压力不稳固,检查腔体真空体系漏率是否正常,检查腔体进气量是否正常。
(3)电缆故障,检查电缆接触是否优秀。
3.1.3成膜质量差
(1)样片外观清洁度差,检查样品外观是否清洁。
(2)工艺腔体清洁度差,清洗工艺腔体。
(3)样品温度非常,检查温控体系是否正常,校准测温热电偶。
(4)膜淀积过程中压力非常,检查腔体真空体系漏率。
(5)射频功率设置不合理,检查射频电源,调整设置功率。
3.1.4淀积速率低
(1)射频输入功率不合适,调整射频功率。
(2)样品温度非常,检查冷却水流量及温度是否正常。
(3)真空腔体压力低,调整工艺气体流量。
3.1.5反应腔体压力不稳固
(1)检查设备真空体系的波纹管是否有裂纹。
(2)检查气体流量计是否正常。
(3)手动检查蝶阀开关是否正常。
(4)真空泵非常,用真空计测量真空泵的抽速是否正常。
3.2影响工艺的因素
影响PECVD工艺质量的因素重要有以下几个方面:
3.2.1极板间距和反应室尺寸
PECVD腔体极板间距的选摘要考虑两个因素:
(1)起辉电压:间距的选择应使起辉电压尽量低,以降低等离子电位,削减对衬底的损伤。
(2)极板间距和腔体气压:极板间距较大时,对衬底的损伤较小,但间距不宜过大,否则会加重电场的边缘效应,影响淀积的均匀性。反应腔体的尺寸可以增长生产率,但是也会对厚度的均匀性产生影响。
3.2.2射频电源的工作频率
射频PECVD通常采用50kHz~13.56MHz频段射频电源,频率高,等离子体中离子的轰击作用强,淀积的薄膜更加致密,但对衬底的损伤也比较大。高频淀积的薄膜,其均匀性显明好于低频,这时由于当射频电源频率较低时,靠近极板边缘的电场较弱,其淀积速度会低于极板中间区域,而频率高时则边缘和中间区域的差别会变小。
3.2.3射频功率
射频的功率越大离子的轰击能量就越大,有利于淀积膜质量的改善。由于功率的增长会加强气体中自由基的浓度,使淀积速率随功率直线上升,当功率增长到肯定程度,反应气体完全电离,自由基达到饱和,淀积速率则趋于稳固。
3.2.4气压
形成等离子体时,气体压力过大,单位内的反应气体增长,因此速率增大,但同时气压过高,平均自由程削减,不利于淀积膜对台阶的覆盖。气压太低会影响薄膜的淀积机理,导致薄膜的致密度降落,容易形成针状况缺陷;气压过高时,等离子体的聚合反应显明加强,导致生长网络规则度降落,缺陷也会增长。
3.2.5衬底温度
衬底温度对薄膜质量的影响重要在于局域态密度、电子迁移率以及膜的光学性能,衬底温度的进步有利于薄膜外观悬挂键的补偿,使薄膜的缺陷密度降落。
衬底温度对淀积速率的影响小,但对薄膜的质量影响很大。温度越高,淀积膜的致密性越大,高温加强了外观反应,改善了膜的成分。
4结束语
以上是对PECVD设备碰到题目的一些领会,PECVD工艺是一门复杂的工艺,要保证淀积薄膜的质量,除了要保证设备的稳固性外,还必须掌握和精通其工艺原理及影响薄膜质量的各种因素,以便在出现故障时,能敏捷分析出导致故障的缘故原由。另外,对设备的日常维护和保养也特别很是紧张。
参考文献:
[1]陈建国,程宇航,吴一平,等.射频-直流等离子体加强化学气相淀积设备的研制[J].真空与低温,1998,4(1):30-34.
[2]H.Nakaya,M.Nishida,YTakeda,etal.PolycrystallineSiliconSolarCells[Z].1192,345-356.
[3]陈萌炯.RF-PECVD和DBD-PECVD制备a-Si:H薄膜的性能研究及其比较[D].浙江:浙江大学,2006.
[4]刘国汉,丁毅,朱秀红,等.HW-MWECR-CVD法制备氢化微晶硅薄膜及其微结构研究[J].物理学报,2002,55(11):6147-6150.
纳米防水网:/

随着电子产品防水需求的不断提高,从原先的 IP54到现在的IP67IP68等级!市场上出现了防水透气膜和防水透音膜,目前这两种不同的材料应用被搞混了,今天便与大家一起讨论防水透气
最近各地降雨量激增,所以手机就难免会沾点水,作为生活中不可或缺的电子产品,防水已经成为一个十分重要重要功能,而且个人对目前的IP68手机市场是相当不满意的。为什么?太贵
自然界中荷叶具有出淤泥而不染的典型不沾水特性(学术上称为Cassie-Baxter状态),具有自清洁、抗结冰、减阻、抗腐蚀等广泛应用价值,而玫瑰花瓣则具有水滴高粘附特性(称为Wenze

派瑞林各种粉材真空镀膜技术加工 纳米涂层防水处理
派瑞林各种粉材真空镀膜技术加工 纳米涂层防水处理

高阻隔强绝缘防汗液涂层蓝牙耳机3C电子产品IPX7纳米材料
高阻隔强绝缘防汗液涂层蓝牙耳机3C电子产品IPX7纳米材料

耐磨超疏水纳米材料 绝缘子架空导线电缆桥梁防覆冰涂层
耐磨超疏水纳米材料 绝缘子架空导线电缆桥梁防覆冰涂层

真空等离子气相沉积技术纳米防水镀膜加工 产能5万片天
真空等离子气相沉积技术纳米防水镀膜加工 产能5万片天

亲水疏油自洁净纳米涂层 易去污 无机防紫外高硬度材料
亲水疏油自洁净纳米涂层 易去污 无机防紫外高硬度材料

台湾超亲水防雾塑料专用 附着力好 透过率高 持久有效
台湾超亲水防雾塑料专用 附着力好 透过率高 持久有效


