电子产品的爬行腐蚀失效
择要:随着欧盟无铅化进展,以及亚太发展中国家环境的赓续恶化,爬行腐蚀征象引起业界的广泛关注。本文通过调研业界相干研究数据,探究了爬行腐蚀的产生机理、影响因素以及可能的预防措施与评估方法。
硫和硫化物是电子产品的天敌,厚膜电阻的硫化失效已为业界熟知(图1)。但随着电子产品无铅化的进展,爬行腐蚀(Creep corrosion)题目也渐渐引起业界的关注(图2)。根据相干报道,这种腐蚀发生的速度很快,甚至有些单板运行不到一年即发生失效。


马里兰大学较早研究了翼型引脚器件上的爬行腐蚀,并对腐蚀机理进行了初步的探究[1,2]。与枝晶、CAF类似,爬行腐蚀也是一个传质的过程,但三者发生的场景、生成的产物以及导致的失效模式并不完全雷同,详细对比见表1。

爬行腐蚀的机理
马里兰大学的PingZhao等认为,爬行腐蚀过程中首先发生的是电化学反应,同时伴随着体积膨胀以及腐蚀产物的消融/扩散/沉淀[1]。即,首先是铜基材被氧化失去一个电子(可能伴有贵金属如Au等的电偶加速作用),生成一价铜离子并消融在水中。因为腐蚀点附近离子浓度高,在浓度梯度的驱动下,一价铜离子会自觉地向四周低浓度区域扩散。当环境中相对湿度降低、水膜变薄或消散时,部分一价铜离子会与水溶液中的硫离子等结合,生成响应的盐并沉积在材料外观,如图3所示。
![]()
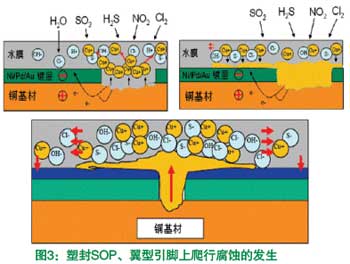
爬行腐蚀的产物以硫化亚铜为主,这是一种P型半导体,不会造成短路的立即发生;但随着其厚度的增长,其电阻减小。此外,该腐蚀产物的电阻随湿度的转变急剧转变,可从10M欧姆降落到1欧姆[2]。
环境因素的影响
温度从化学反应动力学的观点来看,温度升高,化学反应速率会加快,但相对湿度也会降低。因此,现实温度到底在多大程度上影响了爬行腐蚀的速率目前尚不明确。
湿度
业界研究注解,只需50%的湿度,PCB外观就会形成一层水膜。Leygraf,C等人的研究认为,随着相对湿度从0~80%之间转变,干净金属外观可沉积2~10分子层的水膜[3]。

根据爬行腐蚀的消融/扩散/沉积机理,湿度的增长应该会加速硫化腐蚀的发生。PingZhao等人认为,爬行腐蚀的速率与湿度呈指数关系[1]。Craig Hillman等人在混合气体实验研究中发现, 随着相对湿度的上升,腐蚀速率急剧增长,呈抛物线状[4]。由图4可见,当湿度从60%RH增长到80%时,腐蚀速率变为原来的将近3.6倍。此外,作者也指出,此规律仅适用于铜的硫化;对于银而言,湿度增长,腐蚀速率无显明转变。
电压梯度
马里兰大学的PingZhao、Michael Pecht等设计了SIP假件,并向引脚间施加0~20V不等的电压(图5),在Telcordia OutdoorMFG Ⅱ级实验15天后,加/不加电压的SIP的引脚均出现了腐蚀,且腐蚀程度也无显明差别。作者认为,电压对爬行腐蚀无显明影响[2]。
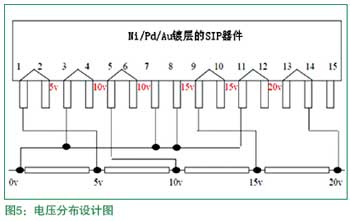
腐蚀性气体种类与浓度的影响
业界公认硫化氢是可以导致爬行腐蚀的,这已被大量的案例和实验证实。HP认为,对于电子产品,环境硫化氢的浓度最高不能超过4.2ug/m3(正常大气中硫化氢浓度约为0.5 ug/m3)[5]。
单纯的二氧化硫是否可以导致爬行腐蚀,目前还没有明确结论。Leygraf,Rice的认为二氧化硫是导致Ni腐蚀的重要因素[3]。西安中大科技有限公司的赵晓利、张宝根等人通过化学方法制备了10±3ppm的SO2气氛,并将铜片置于其中。实验效果发现,40±2℃、96小时后,铜片外观生成大量黑色腐蚀产物;作者认为是CuSO4与CuS的混合物[6]。
M.Reid、Abbott用MFG实验研究了SO2的影响,混合气体实验中(H2S 100ppb,NO2 200ppb,Cl210ppb),SO2的量则分为0、100、200ppb三个等级。实验发现。三种条件对铜的腐蚀并无显明区别。但作者也指出,因为实验中使用的是纯铜而不是镀镍的样品,因此建议混合气体实验中仍然保留二氧化硫[7]。
Rice认为,爬行腐蚀的隐蔽期和爬行距离取决于Cl2浓度[4],爬行的倾向与湿度直接相干。Haynes在不同气氛中的实验注解,爬行腐蚀(以腐蚀产物的厚度和爬行距离表征)程度有以下排序[8]:高Cl2-高H2S> 高Cl2-低H2S > 低Cl2-高H2S;好像也从侧面说明氯气的确有加速爬行腐蚀的作用。
M. Reid、Abbott在MFG实验中发现NO2对铜、银的腐蚀影响不显明。作者在现实环境中的长期实验注解,NO2对于银的腐蚀的确有加速作用,但并未提及对铜的影响。
PCB/器件的设计、加工与组装
爬行腐蚀除了可以在PCB上发生外,其在连接器、SIP等翼型引脚器件上也会出现。相干研究注解,PCB、器件的设计与制造,后续SMT组装均会对爬行腐蚀的发生产生影响。
基材和镀层
Conrad研究了黄铜、青铜、铜镍三种基材,Au/Pd/Sn-Pb三种镀层结构下的腐蚀速率[9],实验气氛为干/湿硫化氢。效果发现:基材中黄铜抗爬行腐蚀能力最好,Cu-Ni最差;外观处理中Sn-Pb是最不容易腐蚀的,Au、Pd外观上腐蚀产物爬行距离最长。
赵晓利、张宝根等认为,镀金层的微孔率对其抗腐蚀性能有很大影响,只有当金的厚度> 5 u m时,才基本上无孔洞,此时才有较好的抗腐蚀能力[ 6 ](图6)。与镀金层类似, 镀镍层也是多孔性的,因此NiAu镀层在硫化气氛下同样会发生腐蚀。
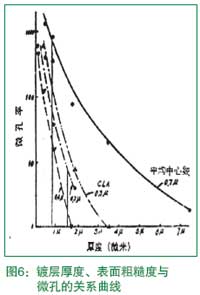
Pecht等人认为,可以用“外观扩散系数”来定义腐蚀产物在某些外观上的运动性[2]。研究注解,金、钯都有很高的外观扩散系数。对于单板而言,腐蚀产物爬行路径多为塑封体、阻焊、连接器基座等复合材料,至于这些材料的“外观扩散系数”有多大,其外观特征如何影响爬行腐蚀,目前业界未见报道。
PCB设计
Alcatel-Lucent、Dell、Rockwell Automation[10, 11, 12] 等公司研究了不同外观处理的单板抗爬行腐蚀能力,认为HASL、ImSn抗腐蚀能力最好,OSP、ENIG适中,ImAg最差。
Alcatel-Lucent认为各外观处理抗腐蚀能力排序如下:ImSn~HASL>> ENIG> OSP > ImAg。
Dell的Randy研究认为,当焊盘为阻焊定义时,因为绿油侧蚀存在,PCB露铜会较为紧张,因而更容易腐蚀(图7)。采用NSMD方式可有用进步焊盘的抗腐蚀能力[11]。
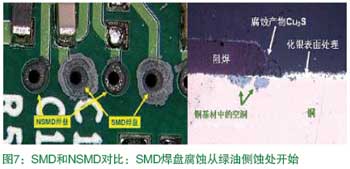
翼型引脚器件
某些翼型引脚器件引脚存在dam-bar切口,或后续成型造成折弯处镀层破损,从而成为硫化气氛下的腐蚀风险点。图8是马里兰大学的Ping Zhao、Michael Pecht在混合气体实验中的样品,可以看到腐蚀产物在塑封体上蔓延,造成了多个引脚搭接。
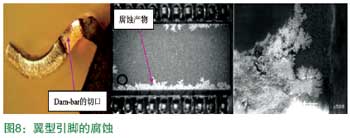
单板组装
1、回流
回流的热冲击会造成绿油局部产生细小剥离,或某些外观处理的破坏(如OSP),使电子产品露铜更紧张,爬行腐蚀风险增长。因为无铅回流温度更高,故此题目尤其值得关注。
2、波峰焊助焊剂
据报道,在某爬行腐蚀失效的案例中,腐蚀点均发生在夹具波峰焊的阴影区域四周,因此认为助焊剂残留对爬行腐蚀有加速作用[13]。其可能的缘故原由是,一方面助焊剂比较容易吸潮,造成局部相对湿度增长,反应速率加快;另一方面,助焊剂中含有大量污染离子,酸性的H+还可以分解铜的氧化物,因此也会对腐蚀有肯定的加速作用。
PCBA防护措施
涂覆无疑是防止单板腐蚀最有用的措施之一。此外,通过一些新材料的应用也可以提拔抗腐蚀能力。Cookson的Jim Kenny等人认为,在化银PCB外观沉积上一层自组装分子膜(图9),可以提拔化学银单板的抗腐蚀能力[14]。
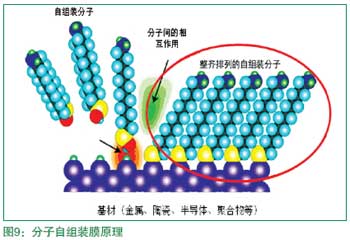
相干评估方法
目前业界常用MFG实验来评估电子产品的抗爬行腐蚀能力,试验箱如图10所示。腐蚀气体从钢瓶出发,按照设定比例与空气混合后进入试验箱。实验箱带有温湿度控制体系,且可对箱体内腐蚀气体浓度进行监控,以便气体浓度降落后及时增补。此外,根据所用气体种类的不同,试验箱后带有响应的废气回收装配。

Battelle Labs、EIA、IEC、Telcodia等行业组织都发布了MFG实验方法,但各种方法的实验条件不一(如BattelleLabs四个等级的实验都不用SO2),缺乏同一的标准。另根据MacDermid的实验数据,现有MFG实验条件加速应力
过低,并不能有用地复现爬行腐蚀失效[15]。这也是2010年iNEMI筹建项目组进行板级MFG实验方法研究的缘故原由。

因为粘土中含有大量的单质硫,因此也常用于简易硫化实验。通常的做法是:将粘土装入纸杯后用水打湿,放入密闭腔(图11),再在50℃下保持30分钟左右掏出,在透风处静置。上述步骤天天重复2次。还有人通过化学反应产生硫化气氛,如NaHS和稀硫酸混合生成硫化氢。与昂贵的MFG实验相比,粘土法、化学法比较经济,操作方便。但瑕玷是二者无法正确地控制气氛浓度,因此一样平常只用做不同样品的优劣对比。

行业研究近况与方向
不难看出,随着全球工业化的发展,大气将进一步恶化,爬行腐蚀受到了电子产品业界自元器件供给商/PCB制造商/OEM厂商以及研究机构的普遍关注。
截至当前的研究效果注解,需从以下的维度体系考虑规避措施:设计上要削减PCB/器件露铜的概率;来料方面需控制加工质量;组装过程要削减热冲击及污染离子残留;整机设计要增强温湿度的控制;机房选址应避开显明的硫污染源。最后,为评估产品的抗腐蚀能力,合适的可靠性实验评估方法也是必须的。
目前,iNEMI在研究爬行腐蚀的影响因素,并旨在建立合适的MFG实验方法和更正确的加速模型。虽有部分厂商宣称已解决了此题目,但总的来看,业界仍迫切必要增强两个方向上的研究:
1、腐蚀机理。大气中的哪些硫化气氛(如二氧化硫、单质硫、有机硫化物等)会导致爬行腐蚀;腐蚀的发生是否存在湿度门槛值;产物爬行的机理和驱动力是什么,物质外观特征,比如不同外观处理/绿油,连接器塑封材料等对爬行腐蚀有什么影响;等等方面,目前均未有公认的结论。
2、评估方法。当前各种标准的MFG测试方法最早均源自于连接器触点腐蚀的评估,其加速模型建立也源于纯金属片的腐蚀失重数据,均未针对PCB的爬行腐蚀机理。虽然在许多报道中均认为行使此测试环境可以复现爬行腐蚀,但在如湿度,二氧化硫浓度等等诸多因素的影响上均存在争议,其加速模型也普遍被认为无法适用。
期待各研究机构与业界企业增强联合,在以上领域深入研究,尽早规避爬行腐蚀带来的风险。
参考资料:
[1]Ping Zhao, Michael Pecht, “CREEP CORROSION OVER PLASTICENCAPSULATEDMICROCIRCUIT PACKAGE WITH NOBLE METAL PREPLATEDLEADFRAMES”,
University of Maryland, Dissertation for thedegree of Doctor of Philosophy, 2005.
[2] Ping Zhao, Michael Pecht, “Field failure due to creep corrosiononcomponents with palladium pre-plated leadframes”,MicroelectronicsReliability, Volume 43, Issue 5, May 2003.
[3] Leygraf, C., Graedel, T.E., “Atmospheric Corrosion”, John Wiley &Sons Inc, New York, 2000.
[4] D. W. Rice, P. Peterson, E. B. Rigby, P. B. P. Phipps, R. J.Cappell, andR. Tremoureux, “Atmospheric Corrosion of Copper andSilver”, J.Electrochem. Soc, Volume 128, Issue 2, February 1981.
[5] Helen Holder, “Summary of WHO (APMA) Air Quality Data for Asiaand ISA vs IEC”, HP, August 2009.
[6] 赵晓利, 张宝根, “金镀层外观腐蚀机理及抗腐蚀性珍爱”, 电子工艺技术, 2005 26(6) .
[7] M. Reid,”Summary of Battelle 8th Progress Report: Studies ofNaturaland Laboratory Environmental Reactions on Materials andComponents”,University of Limerick.
[8] Haynes, G., and Baboian, R., “Creep in Mixed Gas Tests,” MaterialsPerformance, vol. 29, Sep. 1990.
[9] Conrad, L.R., Pike-Biegunski, M.J., Freed, R.L, “CreepCorrosionover Gold, Palladium, and Tin-lead Electroplate,” TheFifteenth AnnualConnectors and Interconnection Technology symposiumProceedings,pp.401-14, Fort Washington, PA, USA, 1982.
[10] C. Xu,W. Reents, J. Franey, J. Yaemsiri and J. Devaney, “CreepCorrosion ofOSP and ImAg PWB Finishes”, Alcatel-Lucent, IPC APEX2010.
[11] R. Schueller, W. Ables, and J. Fitch, “Creep Corrosion of OSP andImAg PWB Finishes”, SMTA International, October 2007.
[12] Robert Veale, Rockwell Automation, “RELIABILITY OF PCBALTERNATESURFACE FINISHES IN A HARSH INDUSTRIALENVIRONMENT”SMTA International,September 2005.
[13] C. Xu, J. Franey, D. Fleming, and W. Reents, “Creep Corrosion onLead-free PCBs”, Alcatel-Lucent, IPC APEX 2009.
[14] Jim Kenny, Karl Wengenroth, Ted Antonellis, ShenLiang Sun, Dr.CaiWang, Edward Kudrak, Dr. Joseph Abys, Enthone Inc, “PWBCREEPINGCORROSION MECHANISM AND MITIGATION STRATEGY”,CooksonElectronics, March 2008.
[15] Lenora Toscano, Ernest Long,Ph.D., and John Swanson, “CREEPCORROSION ON PCB SURFACES: IMPROVEMENTSOF PREDICTIVETEST METHODS AND DEVELOPMENTS REGARDING PREVENTION
TECHNIQUES,”MacDermid.
更多纳米防水资讯请关注纳米防水微信号: nanowp

随着电子产品防水需求的不断提高,从原先的 IP54到现在的IP67IP68等级!市场上出现了防水透气膜和防水透音膜,目前这两种不同的材料应用被搞混了,今天便与大家一起讨论防水透气
最近各地降雨量激增,所以手机就难免会沾点水,作为生活中不可或缺的电子产品,防水已经成为一个十分重要重要功能,而且个人对目前的IP68手机市场是相当不满意的。为什么?太贵
自然界中荷叶具有出淤泥而不染的典型不沾水特性(学术上称为Cassie-Baxter状态),具有自清洁、抗结冰、减阻、抗腐蚀等广泛应用价值,而玫瑰花瓣则具有水滴高粘附特性(称为Wenze

派瑞林各种粉材真空镀膜技术加工 纳米涂层防水处理
派瑞林各种粉材真空镀膜技术加工 纳米涂层防水处理

高阻隔强绝缘防汗液涂层蓝牙耳机3C电子产品IPX7纳米材料
高阻隔强绝缘防汗液涂层蓝牙耳机3C电子产品IPX7纳米材料

耐磨超疏水纳米材料 绝缘子架空导线电缆桥梁防覆冰涂层
耐磨超疏水纳米材料 绝缘子架空导线电缆桥梁防覆冰涂层

真空等离子气相沉积技术纳米防水镀膜加工 产能5万片天
真空等离子气相沉积技术纳米防水镀膜加工 产能5万片天

亲水疏油自洁净纳米涂层 易去污 无机防紫外高硬度材料
亲水疏油自洁净纳米涂层 易去污 无机防紫外高硬度材料

台湾超亲水防雾塑料专用 附着力好 透过率高 持久有效
台湾超亲水防雾塑料专用 附着力好 透过率高 持久有效


